TOF-SIMS、D-SIMS:二次イオン質量分析法
概要
半導体製造工程において、不純物混入は特性や製造歩留まりの低下につながるため、早急な不純物 元素の特定および量の把握が重要です。
MSTではTOF-SIMS(Static-SIMS)で不純物元素を定性し、検出された元素をD-SIMS(Dynamic-SIMS)で 深さ方向へ定量するという、デバイス中の不純物評価が可能です。
本件では、無アルカリガラス中の金属不純物を測定した事例を紹介します。
TOF-SIMSとD-SIMSの特徴
TOF-SIMSとD-SIMSの特徴を以下にまとめます。
| 定性 | 定量 | 検出下限 (オーダー) | 評価元素 | 特徴 | |
| TOF-SIMS | 〇 | △ | 数十ppm | H~ 元素指定:不要 | 高い質量分解能 |
| D-SIMS | △ | 〇 | ppb~ppm | H~ 元素指定:必要 | 豊富な標準試料に よる定量値換算 |
両手法の特徴を活かした分析方法がおすすめです。

TOF-SIMS データ
TOF-SIMSは不純物元素の定性が可能です。無アルカリガラス内部のマススペクトルを取得しました。 マススペクトルの結果より、下記の金属元素が確認されました。

D-SIMS データ
D-SIMSは深さ方向の不純物濃度分布を評価します。サンプルを冷却しながら測定することで、SiO2中 アルカリ金属元素の濃度分布を高精度で評価可能です(分析事例C0208)。
TOF-SIMSで検出された元素について、D-SIMSで標準試料を用いて定量値を算出しました。
各金属不純物は、100ppmから数%程度の濃度であることがわかりました。
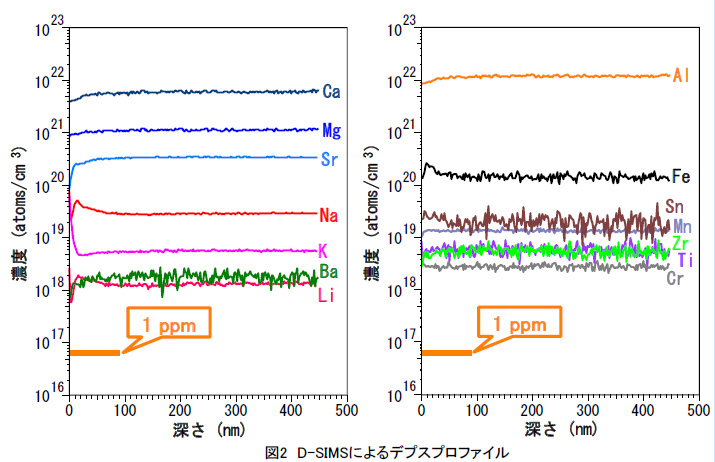
定量可能な元素の例
D-SIMSでは、SiO2中の軽元素および金属元素は60種類以上定量可能です。
軽元素 :H, C, N, F, P, S, Clなど
金属元素 :Li, Na, Mg, Al, K, Ca, Ti, Cr, Mn, Fe, Sr, Zr, Sn, Baなど
測定可能深さ
D-SIMSでは、数十μm程度の深さまで評価可能です。
測定領域
TOF-SIMS、D-SIMSは数十μm角程度の領域の評価が可能です。









