試料冷却による高精度なBのプロファイル分析
概要
デバイスの設計の上で特性に大きく影響を与えるSi中Bの濃度分布は、SIMS分析により高感度・高深さ方向分解能での評価が可能です。 しかし、一般的な分析条件では、測定起因によりBの濃度分布に歪みが生じることがわかりました。
MSTでは試料冷却がこの歪み補正に有効であることを確認し、より高精度な濃度分布の評価が可能になりました。
データ
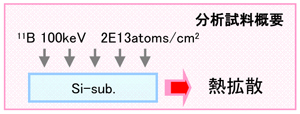
試料表面側の領域と深い低濃度領域で測定に起因するゆがみが発生します。また試料に対して測定方向を変えた試料基板側からの分析(試料表面側に着目)においても、ゆがみが発生します。
※基板側からの分析:SSDP-SIMS(Substrate Side Depth Profile-SIMS)










