TOF-SIMSで無機物の分子情報を深さ方向に捉えることが可能
概要
TOF-SIMSで得られる分子情報の深さ方向分析では、(1)深さ方向分解能が良い、(2)酸化物・窒化物・フッ化物・炭化物・合金・金属など無機物の化学状態の区別が可能、(3)微量な状態の評価が可能、(4)OHのモニターが可能、(5)相対的なサンプル間の比較(膜厚・組成)が可能、(6)イメージ分析により表面数nm程度について状態の分布を視覚的に捉えた評価が可能です。
以下に自然酸化膜と酸化膜の結果をまとめます。
データ
自然酸化膜と10nmの酸化膜のTOF-SIMSによる測定結果を以下にまとめます
自然酸化膜と酸化膜とSi基板では特徴的なピークが異なること、自然酸化膜と酸化膜界面の特徴的なピークが似ていることがわかります。
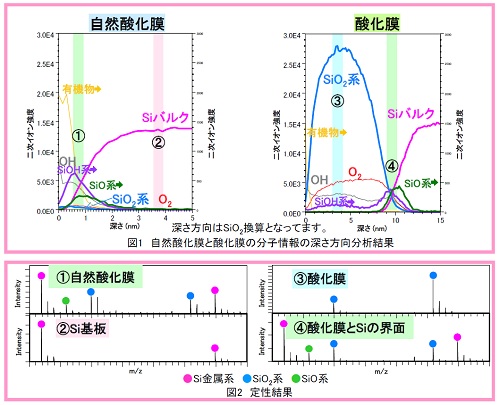
分子情報の深さ方向分析の参考出典;Harumi Masudome et.al.,Surf.InterfaceAnal.2011,43,664-668









