TOF-SIMSで無機物の分子情報を深さ方向に捉えることが可能
概要
Siトランジスタのゲート酸化膜として用いられているSiON膜はリーク電流を抑えるため、Si酸化膜にNを導入して形成されます。基板との界面特性を良好にしながら誘電率を確保するには、SiON膜中のNの分布を厳密に制御する必要があります。1nm膜厚のSiON膜中でのSi酸化物・窒化物の分布をTOF-SIMSを用いて評価した事例をご紹介します。TOF-SIMSは表面で高い深さ方向分解能を持ち、感度良く分子情報を得ることができるため、SiON極薄膜中の組成分布を明瞭に得ることができます。
データ
膜厚1nmのSiON膜(窒素濃度は約1%)について、深さ方向でのSiの状態分布を示します。
1%の窒素の深さ方向分布を感度良く得ることができました。
また、イメージ分析により表面数nm程度について状態の分布を視覚的に捉えた評価が可能です。
XPSやSIMSと併用することで、濃度の定量評価も可能です。
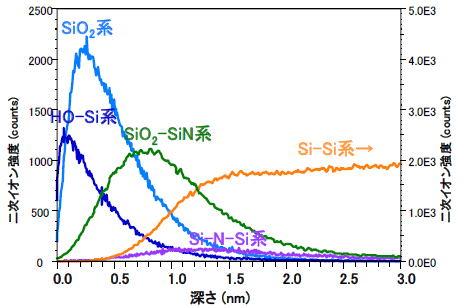
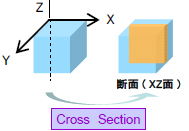 | Z=3nm | |||
 |  |  |  | |
| HO-Si-O | O-Si-O-Si-O | Si-N-Si | Si-Si | |









