前処理により化合物層を選択的に除去してから分析が可能
概要
積層構造試料のSIMS分析において、試料表面から深い位置に着目層がある構造では、着目層で深さ方向分解能の劣化や上層の濃度分布の影響を受ける懸念があります。このような場合には、前処理により上層を除去してから分析することが有効です。
本資料では、 InP/InGaAs系 SHBT(Single Heterojunction Bipolar Transistor)試料について、選択的かつ段階的に層を除去した例を示します。
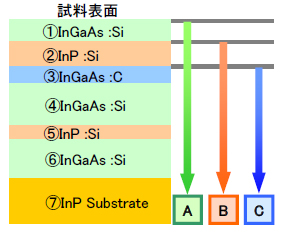
データ
InP/InGaAs系 SHBT構造試料(図1)について、下記の3種類のSIMS分析を行った結果を図2に示します。
- A:試料表面から測定
- B:試料表面から①InGaAs層を除去後、②InP層から測定
- C:試料表面から②InP層までを除去後、③InGaAs層から測定
このように、InP/InGaAs系化合物積層構造試料において、前処理により各層を選択的かつ段階的に除去してから分析することが可能です。
この方法は、LEDの活性層の評価などに有効です。
A:試料表面から測定

B:②InP層から測定

C:③InGaAs層から測定

図2 InP/InGaAs系SHBT構造試料のSIMS分析結果









