GCIB(Arクラスター)を用いることで損傷層の成分・厚さ評価が可能
概要
高分子材料の表面にイオン照射を行うことにより、表面特性の変化が生じます。この変化を利用し、機能性材料の開発など広い分野で研究が行われています。イオン照射後、表面状態にどのような変化が生じたのか評価することは、効率的な研究・開発に重要です。
TOF-SIMS分析では、スパッタイオンビームにGCIB(Gas Cluster Ion Beam)を用いることで、高分子材料表面のイオン照射による損傷層(ダメージ層)の成分・厚さを評価することが可能です。
データ
実験概要
- サンプル:芳香族系のCHで形成されるポリスチレン。
未照射のサンプルと、損傷層形成のためCsイオン、酸素イオンを2keVにて照射したサンプルを用意。 - スパッタイオン源にGCIBを用い、TOF-SIMSの深さ方向分析を行いました。
結果
- 未照射(図1)から、表面汚染が除去されており、深くなるにつれポリスチレン由来のピークが強くなった後ほぼ一定となることが確認できます。この結果から、TOF-SIMSによりポリスチレンの深さ方向分析が可能であることがわかります。
- Csイオン照射(図2)から、カーボン層が表面に形成されていることがわかります。
- 酸素イオン照射(図3)から、Csイオン照射に比べカーボン層が厚く形成していることがわかります。
※ポリスチレン由来のピークはC7H7、C15H13を用いました。
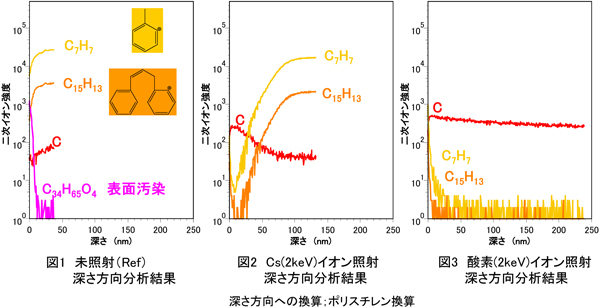
これらの結果より、TOF-SIMSにより高分子表面に形成される損傷層の成分や厚さの評価が可能であることがわかりました。









