PLマッピングで検出した結晶欠陥の高分解能TEM観察
概要
PL(フォトルミネッセンス)マッピングでは、発光箇所から結晶欠陥位置の特定が可能です。
更に同一箇所を高分解能STEM観察(HAADF-STEM像)を行うことで積層欠陥を捉えることができます。
本事例では、市販のSiCパワーデバイスについてPLマッピングとSTEM観察を用いて調査を行いました。
PLマッピングにより積層欠陥位置を特定後、欠陥端部分についてFIB加工を行い、断面STEM観察を実施しました。
データ
サンプル概要
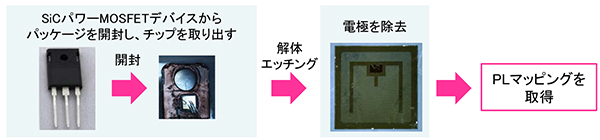
分析結果
PLマッピングにより積層欠陥位置が確認できました。
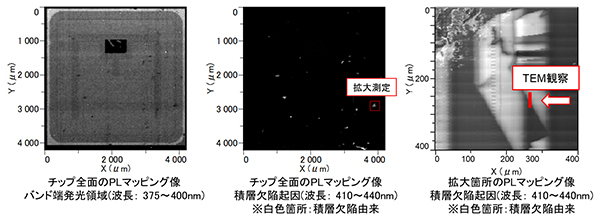
特定した欠陥端部分について、FIB加工を行い、断面観察を実施しました。
Bright-field-STEM像においてデバイス表面から4.6μmの位置に欠陥を確認しました。
欠陥部分の高分解能HAADFSTEM像を取得し、原子配置のずれからSSF*1(3,1)であることが確認できました。
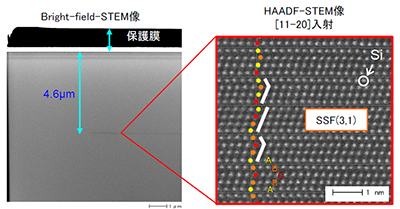
*1: SSF (Shockley-Type Stacking Fault) ショックレー型積層欠陥









