基板上の極薄膜についてデプスプロファイルを評価可能です
概要
角度分解XPS(ARXPS)はX線照射によって放出される光電子を取出角ごとに検出し、それぞれ検出深さの異なるスペクトルを用いてサンプル表面極近傍のデプスプロファイルを評価する手法です。従来のArイオンスパッタを用いた方法と比較すると、深さ方向分解能が向上し、かつ選択スパッタやミキシングによる組成変化が無いといったメリットがあり、基板上の極薄膜(数nm程度)のデプスプロファイル評価に有効です。
本資料ではSi基板上のSiN膜について、膜中の組成分布評価を行った事例をご紹介します。
データ
ARXPSによるデプスプロファイル算出の模式図
※ARXPS : Angle Resolved XPS
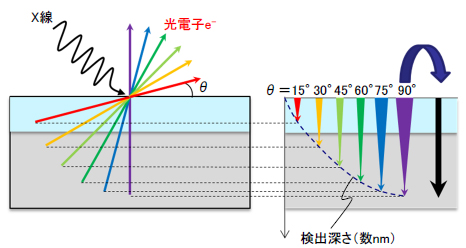

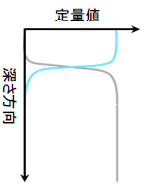
✓光電子量は表面側で多く、深さ方向で指数関数的に減少
✓各取出角のスペクトルを再現するデプスプロファイルを算出
✓各取出角のスペクトルを再現するデプスプロファイルを算出
測定例:Si基板上SiN膜のデプスプロファイル










