めっきなどの膜中・界面の不純物をTOF-SIMSで評価できます。
概要
成膜装置部品、ターゲット材、めっき液などからデバイス中に不純物が混入し、悪影響を与えるため、表面、膜中や界面の不純物の定性評価が重要です。TOF-SIMSでは下記3つの特徴から一度の測定で表面、膜中や界面に存在する未知の元素を高感度に評価することが可能です。
①金属元素の場合、一度の測定でm/z 1から800のイオンを同時に検出できること
②数ppmの検出感度が得られること(材料・各イオンにより変動)
③スパッタガンを用いることで深さ方向の分布を評価できること
データ
サンプルを表面からSiウエハまで深さ方向に測定し、金(Au)膜中とAu/Si界面近傍のそれぞれのマススペクトルを抽出した結果(図1,2)と材料(Au, Si)および不純物のデプスプロファイル(図3)を示します。

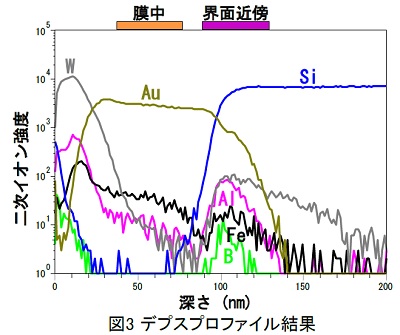
~測定結果から推定されること~
Al, Fe, Wは表面近傍、Au膜中、界面近傍から検出されているため、Au成膜時に不純物として入り込んだ可能性が考えられます。
Bは表面近傍と界面から検出されているため、蒸着時ではなく二次汚染として、成膜前のSiウェハおよび蒸着後のAu表面に存在している可能性が考えられます。
めっきなど、材料の種類によらず金属膜中の不純物を評価できます。
*本資料では、B, Al, Fe, Wのみ記載しておりますがその他の金属も評価可能です。









