ウエハの汚染原因を推定することが可能です
概要
TOF-SIMSは、異物、付着物、汚れ、変色など、工程に起因する汚染の原因究明に非常に有効な手法です。異物などの汚染から得られたマススペクトル情報を、汚染源候補の部品のマススペクトル情報と比較することで、それら汚染源を推測することができます。
本資料では、Siウエハの異物と、ウエハ製造工程の中で使用する樹脂製チューブ4種を準備し、そのマススペクトル情報を比較することで、異物がどの工程で使用する部品に起因する汚染なのか評価しました。
データ
定性結果
異物と汚染源候補である部品チューブA~Dの定性スペクトルを以下にまとめます。異物からは、チューブBで特徴的なCOF系のイオン(▼)が検出されました。
 |
 |
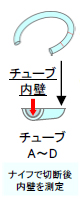 |
| ▼CF系 | ▼COF系 | *PDMS系 | ◆フタル酸系 | |
| 異物 | ● | ● | – | – |
| チューブA | ● | – | – | – |
| チューブB | ● | ● | – | – |
| チューブC | – | – | ● | – |
| チューブD | – | – | – | ● |
考察
異物と部品チューブ4種の定性スペクトルを比較した結果、異物とチューブBがよく一致することがわかりました。これらの結果より、Siウエハ上の異物は、チューブB由来の汚染と推定されます。









